�Ɍ��Q�[�g�\���ɂ��V�X�e���f�B�X�v���C�̒������d�͉�

������\��
���� ��
�i����w�Y�ƉȊw�������@�����j
����18�N�x������
1�D�������{�̊T�v
�@�@��X���J�������V���R���̒ቷ�_���@�u�Ɏ_�_���@�v�𔖖��g�����W�X�^�[�iTFT�j�ɉ��p���āATFT�ƃV�X�e���f�B�X�v���C�̒������d�͉����s���B�Ɏ_�_���@�͏Ɏ_�̕����ɂ���Ĕ�������𗣎_�f�C�I��(O-)�ɂ��V���R���̒��ڎ_���@�ł���AO-�C�I���̎_�������̈ړ��̊������G�l���M�[�ƊE�ʔ����̊������G�l���M�[���������A120���̒ቷ�ŃV���R�����SiO2�����`���ł���B�Ɏ_�_���@��p���ĉ��ʂ̂��鑽�����V���R�����_�������ꍇ�A�\�ʍr�����������ጸ�ł��邱�Ƃ��킩���Ă���B����ɁA�Ɏ_�_�����x�̓V���R���̖ʕ��ʂɈˑ����Ȃ��A�����̖ʂ��I�o���Ă���TFT�p�������V���R�������ɂ��ψ�Ȗ�����SiO2�����`���ł��邱�Ƃ��킩���Ă���B�Ɏ_�_���@�͒��ڎ_���@�ł��邽�߁A��E�ʏ��ʖ��x���̗ǍD�ȊE�ʓ����A�y�э����x���̗ǍD�ȃo���N���������B�����̗��_����A�������V���R��TFT�̃Q�[�g�_�����ɏɎ_�_���@�𗘗p����A����TFT�Ɏg�p����Ă���50�`100nm�̃Q�[�g�_�����̖�����20nm�ȉ��ɒጸ�ł���B�Q�[�g�_�������̒ጸ�ɂ��TFT�̋쓮�d����ጸ�ł��A���̌���TFT�̒������d�͉����\�ƂȂ�B
�@�@���݂�TFT�ł́A�Q�[�g�_��������50nm�ȉ��ɒጸ���邱�Ƃ͍���ł���B���̂��߁A�����������d���쓮�T�u�~�N����TFT�͎�������Ă��Ȃ��B�Ɏ_�_���@�ł̓Q�[�g�_��������ጸ�ł��邽��TFT�̔������\�ƂȂ�A��d���\��TFT��o�b�N�Q�[�g�\��TFT���̐V�\���f�o�C�X�ɂ���Ē����d�͉����s���A����Ƀ������ACPU�A�h���C�o�[�A�A���v�����������V�X�e���f�B�X�v���C�̒������d�͉����ł���B����ɁA�Ɏ_�_������p������d���\��TFT�A�o�b�N�Q�[�gTFT���̐V�\��TFT����H�Z�p�ɂ����p���āA�V��H�Z�p�̊J���ɂ���Ă�TFT�̒����d�͉����s���B���Ȃ킿�A�ޗ��A�v���Z�X�A�f�o�C�X�A�V�X�e�����I�Ɍ����J�����邱�Ƃɂ���ăV�X�e���f�B�X�v���C�̒������d�͉����s���B �B
2�D�������{���e
�P�D�@�Ɏ_�_���@�ɂ��TFT�p�K���X���̑������V���R�������̎_��
�@�@�@ �i�Ɏ_�_���v���Z�X�̌����J���A��ʐϊ��TFT�p�Ɏ_�_�����u�̊J���j
�@�@�{�N�x�����Ɋ�������32�~40cm2�T�C�Y��TFT��̏Ɏ_�_�����u�i�}�P�j��p���āA�������V���R�������̎_�����s���� �B
�@
�@���̏Ɏ_�_�����u�́A�Ɏ_�_�����Ɛ������̓���Ȃ��Ă���B����̎����ł́A�Ɏ_�̉��x�����X�ɏグ116���ȏ�̉��x��ێ����邱�Ƃɂ���đ������V���R�������̎_�����s�����B
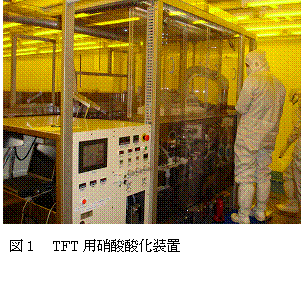
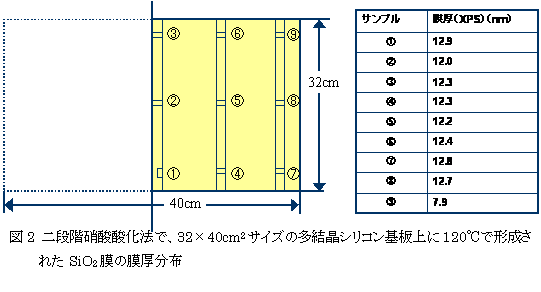
�@�@�}�Q�ɁA32�~40cm2�T�C�Y�̊��Ɍ`�����ꂽSiO2���̖������z�������BSiO2�����́A�G���v�\���[�^�[��p���đ��肵���BSiO2�����́@12.5�}0.5nm�ł���A�������z�́}3~4���i�|�C���g9�������j�ƗǍD�ł���B�|�C���g9�͎�����ێ����Ă����ӏ��ł���A�Ɏ_�Ƃ̒��ڐڐG���W����ꂽ���߂�SiO2�������������Ȃ����ƍl������B
�@�@
�}�R�ɁATFT�p�������V���R�������� �Ɏ_�_��������Ŋϑ�����X�����d�q�X�y�N�g���iXPS�j�������B100eV�ߖT�̎ア�s�[�N�́A�������V���R����Si 2p3/2�y��2p1/2�O��������o�������d�q�ɂ����́A���x�̋����u���[�h�ȃs�[�N��SiO2���ɂ����̂ł���BSiO2���ɂ��s�[�N�́A�������V���R����Si 2p3/2�s�[�N���4.9eV���G�l���M�[���ɑ��݂���B���̑傫�ȉ��w�V�t�g�́A�ǍD�ȓ���������SiO2�����`�����ꂽ���Ƃ������B�����̃s�[�N�̖ʐϋ��x����ASiO2���̖�����12.6nm�ƌ��ς���ꂽ�B���̒l�́A�G���v�\���g���[��茩�ς���ꂽ�����Ɨǂ���v�������Ă���B�ȉ��Ɏ����悤�ɁA�Ɏ_�_���ɂ�葽�����V���R���\�ʂ̕��R�����N����A���̌���XPS����ƃG���v�\���g���[���肪�ǂ���v���������ƍl������B
�B
�Ɏ_�_��������Ŋϑ�����X�����d�q�X�y�N�g���iXPS�j�������B100eV�ߖT�̎ア�s�[�N�́A�������V���R����Si 2p3/2�y��2p1/2�O��������o�������d�q�ɂ����́A���x�̋����u���[�h�ȃs�[�N��SiO2���ɂ����̂ł���BSiO2���ɂ��s�[�N�́A�������V���R����Si 2p3/2�s�[�N���4.9eV���G�l���M�[���ɑ��݂���B���̑傫�ȉ��w�V�t�g�́A�ǍD�ȓ���������SiO2�����`�����ꂽ���Ƃ������B�����̃s�[�N�̖ʐϋ��x����ASiO2���̖�����12.6nm�ƌ��ς���ꂽ�B���̒l�́A�G���v�\���g���[��茩�ς���ꂽ�����Ɨǂ���v�������Ă���B�ȉ��Ɏ����悤�ɁA�Ɏ_�_���ɂ�葽�����V���R���\�ʂ̕��R�����N����A���̌���XPS����ƃG���v�\���g���[���肪�ǂ���v���������ƍl������B
�B
�Q�D�@�Ɏ_�_���@�Ō`�����ꂽ�`10nm SiO2��������MOS�_�C�I�[�h�̓d�C����
�@�@�@ �i�Ɏ_�_���v���Z�X�̌����J���j
�@�@ TFT�p�������V���R�������͈�ʓI�ɐ^�������̂��p�����邽�߁A�d��-�d��(I-V)�������̓d�C�����̑��肪����ł���BI-V�����̑���̂��߁A�{�����ł͒P�����V���R���in�^�ASi(100)�A���R�`1��cm�j���i�K�Ɏ_�_�����A���̌㒼�a0.15mm�̃A���~�j�E��(Al)�d�ɂ��쐻����<Al/SiO2/Si(100)>MOS�\���Ƃ����B�Ɏ_�_����8���ԍs���A�`�����ꂽSiO2���̖�����9nm�ł������B�}4�Ɏ�����I-V�Ȑ����A120���Ō`�����ꂽSiO2���ɂ�������炸�A���[�N�d�����x�����Ȃ�Ⴂ���Ƃ��킩��B���f���͋C��250���Ń|�X�g���^���C�[�[�V�����A�j�[�����{������ɂ́A����Ƀ��[�N�d�����x���ጸ�����BTFT�����H���ɂ́A���̒��x�̉��x�̉��M�����͕K���܂܂�Ă���A�Ɏ_�_���@�ƒቷ�A�j�[��������p����Q�[�g�_�����̌`���ɂ��A��[�N�d���A�����d�͂�TFT���쐻�ł��邱�Ƃ������������ʂ�����ꂽ�B
TFT�p�������V���R�������͈�ʓI�ɐ^�������̂��p�����邽�߁A�d��-�d��(I-V)�������̓d�C�����̑��肪����ł���BI-V�����̑���̂��߁A�{�����ł͒P�����V���R���in�^�ASi(100)�A���R�`1��cm�j���i�K�Ɏ_�_�����A���̌㒼�a0.15mm�̃A���~�j�E��(Al)�d�ɂ��쐻����<Al/SiO2/Si(100)>MOS�\���Ƃ����B�Ɏ_�_����8���ԍs���A�`�����ꂽSiO2���̖�����9nm�ł������B�}4�Ɏ�����I-V�Ȑ����A120���Ō`�����ꂽSiO2���ɂ�������炸�A���[�N�d�����x�����Ȃ�Ⴂ���Ƃ��킩��B���f���͋C��250���Ń|�X�g���^���C�[�[�V�����A�j�[�����{������ɂ́A����Ƀ��[�N�d�����x���ጸ�����BTFT�����H���ɂ́A���̒��x�̉��x�̉��M�����͕K���܂܂�Ă���A�Ɏ_�_���@�ƒቷ�A�j�[��������p����Q�[�g�_�����̌`���ɂ��A��[�N�d���A�����d�͂�TFT���쐻�ł��邱�Ƃ������������ʂ�����ꂽ�B
�R�D�@�C���Ɏ_�_���@�ɂ��Si-MOS�\���̒ቷ�n��
�@�@�@ �i�C���Ɏ_�_���@�̌����j
�@�@�}5�ɁA�V���R����400���̒ቷ�Ŏ_�������ۂɌ`�������SiO2�����Ǝ_�����Ԃ̊W�������B�]���� �����_��������_���ł́A400���̒ቷ�ł̓V���R���͂��܂�_�����ꂸSiO2�����͍ő�2.5nm�ł���B����A�C���Ɏ_�_���ł͎_�����i�s���āA4nm�ȏ�̖���������SiO2�����`���ł��邱�Ƃ��킩�����BI-V����̌��ʁA350���Ō`������SiO2���ł�Poole-Frenkel�@�\�ɂ���āA500���Ō`�������ꍇ��Fowler-Nordheim�@�\�ɂ���ă��[�N�d��������邱�Ƃ����������B
�����_��������_���ł́A400���̒ቷ�ł̓V���R���͂��܂�_�����ꂸSiO2�����͍ő�2.5nm�ł���B����A�C���Ɏ_�_���ł͎_�����i�s���āA4nm�ȏ�̖���������SiO2�����`���ł��邱�Ƃ��킩�����BI-V����̌��ʁA350���Ō`������SiO2���ł�Poole-Frenkel�@�\�ɂ���āA500���Ō`�������ꍇ��Fowler-Nordheim�@�\�ɂ���ă��[�N�d��������邱�Ƃ����������B
�S�DTFT�p�����ŏ������u�̊J��
�@�@�i�V�K�����Ŗ@�ɂ��TFT�̍����\���ƒ����d�͉��j
�@6�C���`�y��8�C���`�p�����Ō^�����̐�u���A32�~40cm2�T�C�Y��TFT��̌����ŏ������\�ƂȂ�悤�ɉ��������B���̑��u��p���āAHCN���n�t�ɂ��V�K�����ŏ������s�����Ƃ��ł���B
�T�D�Ɏ_�_���@�ɂ�鑽�����V���R���̃��b�W�ጸ�i���R���j
�@�@�i�Ɏ_�_���v���Z�X�̌����J���j
�@�@�������V���R��TFT�̓K���X���Ƀv���Y�}CVD�@��p���ăA�����t�@�X�V���R����͐ς��āA��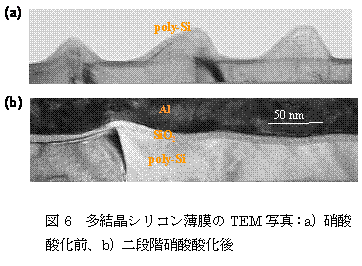 ������[�U�[�A�j�[�����Č��������邱�Ƃɂ���č쐻�����B���[�U�[�A�j�[����̗�p�ߒ��ŁA�\�ʂɓˋN���i���b�W�j����������i�}6a�j�B���ʂ̂���\�ʂ�CVD���̑͐ϖ@��p���ăQ�[�g�_�������`������A�ʂ̕����Ŏ_���������������Ȃ肱�������[�N�d���������B���[�N�d����h�~���邽�߃Q�[�g�_������50�`100nm�ƌ�������K�v������A���̌��ʋ쓮�d��������������d�͂��傫���Ȃ�B�܂��A���b�W�̑��݂͔��\���̍쐻������ɂ��ĕ������ቺ������B
������[�U�[�A�j�[�����Č��������邱�Ƃɂ���č쐻�����B���[�U�[�A�j�[����̗�p�ߒ��ŁA�\�ʂɓˋN���i���b�W�j����������i�}6a�j�B���ʂ̂���\�ʂ�CVD���̑͐ϖ@��p���ăQ�[�g�_�������`������A�ʂ̕����Ŏ_���������������Ȃ肱�������[�N�d���������B���[�N�d����h�~���邽�߃Q�[�g�_������50�`100nm�ƌ�������K�v������A���̌��ʋ쓮�d��������������d�͂��傫���Ȃ�B�܂��A���b�W�̑��݂͔��\���̍쐻������ɂ��ĕ������ቺ������B
�@�@�}6b�ɁATFT�������V���R��������ɓ�i�K�Ɏ_�_���@��p���Č`������SiO2/�������V���R���\���̒f�ʓ��ߓd�q�������iTEM�j�ʐ^�������B��10nm�̋ψ�Ȗ���������SiO2�����`������Ă��邱�Ƃ��킩��B����ɁA�}6a�Ɣ�r����A�Ɏ_�_���O��50nm�ȏ�̍����ł��������b�W���A�����ȉ��̍����܂Œጸ���Ă��邱�Ƃ��킩��B���������āA�Ɏ_�_���@��p����A���b�W�ጸ�̖ʂ����TFT�̒����d�͉����\�ƂȂ�B
�U�D�Ɏ_�_���@��p����TFT�̎���
�@�i�Ɏ_�����ɂ��CVD�͐ϖ��̉�����TFT�̒����d�͉��A��ʐ�TFT�̏Ɏ_�_���Z�p�̊J���Ǝ���j
�@18�N�x��TFT���삪��r�I�e�ՂȁA�Ɏ_�����@�����������B�Ɏ_�����@�Ƃ́A�v���Y�}CVD�@���̑͐ϖ@�Ō`������SiO2���������Ɏ_�ɐZ�Ђ��邱�Ƃɂ���ĉ���������@�ł���B��N�x�̌����ł́A�Ɏ_�����@�ɂ���ăv���Y�}CVD SiO2���̓d�C�e��-�d��(C-V)���������������サ�āA�M�_������C-V�����Ɠ����x���ɂȂ邱�Ƃ��킩�����B32�~40cm2�T�C�Y�̊��Ƀv���Y�}CVD�@�Ō`�����ꂽSiO2�����Ɏ_�����@��p���ĉ������A���̌�TFT������s�����B���̔������N���炸�ATFT����ɐ��������B����A�d�C�����̑���Ƃ��̌���ɂ��TFT�̒������d�͉����s���\��ł���B
�V�DSPICE�pTFT�f�o�C�X���f���̊J��
�@����18�N�x�͏Ɏ_�_���ɂ��TFT�̍쐻�ɐ旧���A�]���@�ɂ���č쐻����TFT�̎������ʂ���SPICE���f���̍\�z��}�����B
(1)����g�G�����f��
�@�@�`���l����5��m�`20��m��TFT���쐻���A1Hz�`1kHz�͈̔͂Ŏ����E�]���������ʁA���L�̃��f�����ŗ^�����邱�Ƃ��m�F�����B
![]()
�@�@�@(1)
�������ʂ��A��=0.95�`1.05�A��=0.5 ( ID < 1�~10-6A)�A��=1.0 ( ID > 1�~10-6A)������ꂽ�B�܂��A�G���ʂ͒ʏ��MOSFET�ɔ�ׂđ傫���A�����x�A�i���O��H��TFT���g���ہA�G���ɑ���\���Ȕz�����K�v�ł��邱�Ƃ����������B
(2)TFT�f�o�C�X���f��
�@�@���E�ɑ��݂���d�q�ߊl���S(�g���b�v)�������̑����g���b�v�ƒx���g���b�v��2��ނɕ��ނ��A�����̏�Ԗ��x�����w�����ɋߎ����邱�ƂŁATFT�̎㔽�]�̈�Ƌ����]�̈���r�I���m�ɕ\���ł��郂�f�����Ă����B���̃��f���͕\�ʃ|�e���V�����Ɋ�Â��Ă���A���f���p�����[�^�̐������Ȃ����Ƃɓ���������B
�W�D�V�\��TFT�̒��
�@�����œ��삷��TFT�̐M���������߂邽�߁A�f�q�S�̂�Si3N4��(���f�g�U�h�~��)�Ŕ핢����\�����Ă����B���̕����ŁA�𗣂������f�̊g�U��}���A�t���w�����𑣐i����TFT�����̗�}�����邱�Ƃ��ł���B ��Ă̗��R�͉��L�̒ʂ�ł���B�@ TFT�̒�������ɂ������̓o���NMOSFET�̗Ƃ͈قȂ錴���Ő����邱�Ƃ��m�F�����B��������ID/ID�ŕ\���A�e��o�C�A�X�������ł̗��v���������ʁA�w�����I�ȗ������������Ƃ����o�����B�̊����to��TFT�̓��쒆�̉��x(RthIDVD+Text)�����̊��ƂȂ�BRth�͔M��R�AIDVD�̓W���[���M�AText�͊O�����x�ł���B�̊������G�l���M�[��0.25eV�ł��邱�Ƃ���A�����́A�@���G�l���M�[�d�q�ɂ���Đ��������f�̉𗣂ƁA�A�g�U�ɂ�鐅�f�Z�x�̌����A�̑�����ʂɂ�邱�Ƃ�˂��~�߂��B
�X�D�����d�͉�H�Ɋւ��錤��
�@������������\��\���]���w�W(Figure of merit)�Ƃ��ēd�͒x����(Power delay product)���̗p���A����Ɋ�Â�TFT��H�̐��\�]�����J�n�����B
�d�͒x���ς͎����ŗ^������B
![]() �@�@�@�@�@�@�@�@�@�@�@�@�@�@�@�@�@�@(2)
�@�@�@�@�@�@�@�@�@�@�@�@�@�@�@�@�@�@(2)
E�͒P�ʘ_�����Z�ɗv����G�l���M�[�A�т͒x�����Ԃł���B��̎����ATFT��H�̐��\����ւ̓��́A�d���d��VDD��e��C�̒ጸ�ɉ����āATFT�𗬂��d��ID�̑����A����ɂ̓A�[�L�e�N�`���ɂ�郿�̒ጸ�����ƂȂ�B
(1)��d���d�����̌���
�@�@��N�x�ɐv�����X�C�b�`���O�}�g���b�N�X�^TFT�]����H��p���āATFT�̓�������v�I�ɏڂ����]�������B�`���l����L�ƃ`���l����W ��4��m�`100��m�͈̔͂Őv�E���삵��TFT�A240�̂������l�𑪒肵���B���̌��ʁA�������l��炬��VT�́A�A�N�Z�v�^���̓��v�I��炬��NA�������ł͂Ȃ��A�ނ���|���V���R�������̂�炬��tTFT�ɂ����̂ł��邱�Ƃ����o�����B�Ȃ��A�������l�̂�炬��VT�͎����ŗ^������B
![]()
�@�@�@(3)
Cox�͒P�ʃQ�[�g�ʐς�����̗e�ʁA��QB�̓Q�[�g������TFT���Ɋ܂܂��A�N�Z�v�^��(�P�ʖʐϒ�)�̂�炬�ł���B�������l��炬�̗v���ł��鑽�����V���R�������̂�炬��tTFT�̓|���V���R�������[�U�[�A�j�[������ۂ̉ߔM�������ƂȂ��Ă���B
�Ɏ_�_���@�̗��_�����āA�Q�[�g�_����tox�������100nm����20nm���x�ɂ܂Ŕ���������A�������l��炬��VT�͖����ɔ�Ⴕ�ď������Ȃ�̂ŁA����ɔ�Ⴕ�ēd���d�����ጸ�\�ł���B
(2)�u�[�g�X�g���b�vTFT��H�̌���
�@�@�Ɏ_�_���@�ɂ��A�d���d����ጸ���邱�Ƃ͉\�ł��邪�ATFT�̃h���C���d���͈���d���̒ጸ�ɂ�范������B�d��������ƒx�����ԃт����тď�����Ԃ������Ȃ��������Ă���B���������������@�Ƃ��ău�[�g�X�g���b�v��H(BTFT��H: IEEE Asia-Pacific Conference on Circuits and Systems 2004 vol.2, pp.1001-1004)�����������B�g�ݍ��킹�_����H���N���b�N�g�E�u�[�g�X�g���b�v��H�ŋ��ݍ���BTFT��H�̏o�͓d���́|VDD�Ɓ{2VDD�̊Ԃɂ���A���i��TFT�̃Q�[�g�d��VGS��d���d��VDD��2�{�܂ō��߂���B�d���쓮�͍͂ő��4�{�ƂȂ邽�߁A�d���d���̒ጸ�ɂ��x�����Ԃ̒x����ŏ����ɗ}���邱�Ƃ��ł���B�ʏ�̃o���NMOSFET��H�ł͕��̏o�͓d���͋��e����Ȃ����ATFT�̓�����������H�Ƃ��Ċ��҂ł��邱�Ƃ��m�F�����B�����A���̕����ł͈���d���������̂ŁA�Q�[�g�_�����̔j��A�h���C���ߖT�ł̏Փ˓d�����ۂ��������f�o�C�X�\������������K�v������B
�P�O�D�V�X�e���f�B�X�v���C�̒����d�͉��̌����J��
�@�V�X�e���f�B�X�v���C���\������e�V�X�e����H�i�h���C�o�[�ACPU�A���������ADA�R���o�[�^�[�A�A���v���A�������ADSP���j�̑啔���͑������V���R��TFT�@CMOS��H���琬�藧���Ă���B���������āA�V�X�e���f�B�X�v���C�̓����Ԃ̏���d�͎͂��̊�{���ŗ^������B
![]() �@�@�@�@�@�@�@�@�@�@ (4)
�@�@�@�@�@�@�@�@�@�@ (4)
N�͊���������CMOS��H�̓��ڐ��ACL�͕��חe�ʁAV�͓d���d���Af�͓�����g���ł���A�����d�͉��Ɍ������{���I�Ȍ������\�ł���B�d���d�����n�߂Ƃ�����d�����ATFT���x���̗e�ʂƔz���ɋN������e�ʂ��x�z�I�ȗv���ƂȂ��Ă��镉�חe�ʁA���g���ጸ�����̌��ƂȂ�B�t���f�o�C�X�A�V�X�e���A�A�v���P�[�V�����̑��ʂ���A����d�͒ጸ�̕����t�����s�����B
(1) �t���쓮�d���̒�d����
�@�@�d���d���́A�e�t�@���N�V��������������V�X�e����H�Ƃ��ĕK�v�ȓd���ƁA�\���i�t���j�쓮���邽�߂ɕK�v�ȓd���ɕ����邱�Ƃ��ł���B�O�҂͉�H���\������TFT�f�o�C�X�̓������傫�Ȏx�z�I�v���ɂȂ�A��҂͉t���ޗ��̓����Ɉˑ�������̂ŁA�t���ޗ��̒�d�����ɂ��Č������K�v�ł���B�{�����J���ɂ�����t���ޗ��́A�����쓮�d����20���ቺ�i�Ō������A�ŏI�I�ɂ�30���ȉ��̍ޗ���p���邱�Ƃ��ł���ƌ��ʂ��������B
(2) �쓮���g���̒ጸ�A�����I�ȉ�H����
�@�@���o�C���p�r�̉�ʃR���e���c�́A��ɐÎ~��ʁi�O���t�B�b�N�X�A�����j�ł���A�\����ʂ̍X�V�i���t���b�V���j���[�g��傫���ጸ�i�R���P�ȉ��j�ł��邱�Ƃ�A�ҋ@���ȂǕ\���������Ȃ����邱�ƂŁA�\���̃X�L�����G���A�𐧌����邱�ƂŊ�����������H�u���b�N�����Ȃ��ł��邱�Ƃ��������Ă���B
�܂��ʐ^�ȂǓ������F����K�v�Ƃ��Ȃ��������̕\���Ɍ���A�t���𑽒l�쓮�����l�쓮�����H�ɐ�ւ��邱�Ƃ��ł���}���`�h���C�o�[�̓�����i�߁A��w�̒����d�͉���}�邱�Ƃ��ł���Ƃ킩�����B
3�D�������{�̐�
1. �u���сv�O���[�v
(1) �������S�O���[�v���F���с@���i����w�Y�ƉȊw�������A�����j
(2) ��������
- ��ʐ�TFT�p�Ɏ_�_�����u�̊J��
- �Ɏ_�_���v���Z�X�̌����J��
- �Ɏ_�����ɂ��v���Y�}CVD�@�Ō`�����ꂽSiO2�͐ϖ��̓�������
- �V�K�����Ŗ@�ɂ�錇���ʂ̏��ł�TFT�̍����\��
- ��ʐ�TFT�̏Ɏ_�_���Z�p�̊J��
2. �u�J���v�O���[�v
(1) �������S�O���[�v���F�J���@����i����w��w�@�H�w�����ȁA�����j
(2) ��������
- �Ɏ_�_����TFT��SPICE���f���̌����J��
- �V�\��TFT�̌����J��
- �������d��TFT�p�̐V��H�@�\�u���b�N�̌����J��
3. �u����v�O���[�v
(1) �������S�O���[�v���F����@�ɋK�i�V���[�v�i���j�f�B�X�v���C�J���{���V�X�e���Z�p�������A�����j
(2) ��������
- ��ʐ�TFT�̏Ɏ_�_���Z�p�̌����J���Ǝ���
- �������ECPU�����̒������d�͍��@�\SDOG�̌����J��
4�D���ʔ��\��
1. �_���i�����_���j���\�@�i�����@0���A���ہ@12���j
- Y.-L. Liu, M. Takahashi, and H. Kobayashi, Mechanism of Ni removal from Si materials using hydrogen cyanide aqueous solutions, J. Electrochem. Soc. 154(1), H16-H19 (2007).
- K. Imamura, O. Maida, K. Hattori, M. Takahashi, and H. Kobayashi, Low temperature formation of SiO2/Si structure by nitric acid vapor, J. Appl. Phys. 100, 114910-1-114910-4 (2006)
- Asuha, S.-S. Im, M. Tanaka, S. Imai, M. Takahashi, H. Kobayashi, Formation of 10~30 nm SiO2/Si structure with a uniform thickness at ~120 ��C by nitric acid oxidation method, Surf. Sci. 600, 2523-2527 (2006).
- H. Kobayashi, Asuha, S.-S. Im, S. Imai, and M. Takahashi, Nitric acid oxidation of Si method for the formation of high quality Si/SiO2 structure at ~120 ��C, AJAM, 104-108 (2006).
- O. Maida, K. Fukayama, M. Takahashi, H. Kobayashi, Y.-B. Kim, H.-C. Kim, and D.-K. Choi, Interface states for HfO2/Si structure observed by XPS measurements under bias, Appl. Phys. Lett. 89(18) 122112-1-122112-3 (2006).
- S.-S. Im, M. Takahashi, and H. Kobayashi, Room temperature formation of silicon oxynitride/silicon structure by use of electrochemical method, J. Appl. Phys. 100, 044101-1-5 (2006).
- N. Fujiwara, Y.-L. Liu, M. Takahashi, and H. Kobayashi, Mechanism of copper removal from SiO2 surfaces by hydrogen cyanide aqueous solutions, J. Electrochem. Soc. 153 (5), G394-G398 (2006).
- Y.-L. Liu, N. Fujiwara, H. Iwasa, M. Takahashi, S. Imai, and H. Kobayashi, Reaction of cyanide ions with copper on Si surfaces and its use for Si cleaning, Surf. Sci. 600, 1165-1169 (2006).
- H. Kobayashi, Y.-L. Liu, A. Asano, Y. Yamashita, J. Ivan?o, and M. Takahashi, Methods of observation and elimination of semiconductor defect states, Solar Energy, 80, 645-652 (2006).
- H. Kobayashi, T. Sakurai, Y. Yamashita, T. Kubota, O. Maida, and M. Takahashi, A method of observation of low density interface states by means of X-ray photoelectron spectroscopy under bias and passivation by cyanide ions, Appl. Surf. Sci. 252, 7700-7712 (2006).
- S. Imai, M. Fujimoto, Asuha, M. Takahashi, and H. Kobayashi, Formation of atomically smooth SiO2/SiC interfaces at ~120 ��C by use of nitric acid oxidation method, Surf. Sci. 600, 547-550 (2006).
- M. Takahashi, Y.-L. Liu, N. Fujiwara, H. Iwasa, and H. Kobayashi, Silicon cleaning and defect passivation effects of hydrogen cyanide aqueous solutions, Solid State Commun. 137, 263-267 (2006).
2. �����o��
1) ����18�N�x�����o��i�����@2���A�C�O�@1���j
2) CREST�������ԗݐό����i�����@4���A�C�O�@1���j




