極限ゲート構造によるシステムディスプレイの超低消費電力化

研究代表者
小林 光
(大阪大学産業科学研究所 教授)
平成17年度研究報告
1.研究実施の概要
本プロジェクトでは、我々が開発した新規半導体低温酸化法である「硝酸酸化法」を利用して、液晶ディスプレイ駆動などに用いられる薄膜トランジスター(TFT)とシステムディスプレイの超低消費電力化を目指す。比較的低濃度の硝酸と共沸硝酸を用いて酸化を行なう「二段階硝酸酸化法」では、121 ºCの低温で10nm以上の膜厚を持つ二酸化シリコン(SiO2)膜が形成できる。直接酸化法であるため、従来のSiO2低温形成法であるプラズマ気相成長法(CVD法)に比較して格段に良質のSiO2膜が形成でき、さらに凹凸のある多結晶シリコン表面にも均一な膜厚のSiO2膜が形成できる。したがって、従来は50nm程度の膜厚が必要であったTFTのゲート酸化膜の膜厚が20nm以下に低減でき、その結果TFTの駆動電圧が低減でき、大幅な低消費電力化が達成できる。さらに、硝酸酸化法を用いれば、ゲート酸化膜の薄膜化が可能であることから、TFTの微細化が可能となり、バックゲート構造TFT等の新構造により低消費電力化を行い、さらにCPU、ドライバー、アンプ等を内蔵することによるシステムディスプレイの超低消費電力化を行う。硝酸酸化法では120 ºCの低温でSiO2膜が形成できるため、現在のガラス基板に替わりPETなどのプラスチック基板上にTFTが創製でき、フレキシブルディスプレイが達成できると期待される。さらに、新構造デバイスの回路技術を開発することによってもTFTの低消費電力化を行なう。すなわち、本プロジェクトでは材料、デバイス、システムを総合的に研究開発することによって、システムディスプレイの超低消費電力化を行なう。
2.研究実施内容
多結晶シリコンTFTの基本構造は、<金属/SiO2/多結晶シリコン>MOS構造である。17年度は、二段階硝酸酸化法を用いて単結晶シリコンMOS構造を創製してその良好な電気特性を確認すると共に、凹凸のある多結晶シリコン薄膜上にも均一な膜厚でSiO2膜が形成できることを確認した。
n型及びp型Si(100)及びSi(111)ウェーハやガラス基板上に堆積されたi型多結晶シリコン薄膜を、RCA法を用いて洗浄後、希フッ化水素酸水溶液でエッチングした。これらのシリコン試料を、濃度40重量%で108 ºCで沸騰している硝酸に浸漬し、その後濃度68重量%、沸点121 ºCの共沸硝酸に浸漬することによって酸化した。単結晶シリコンについては、酸化後直径0.3mmのアルミニウム電極を形成して、<Al/SiO2/Si>MOS構造とした。
 表1 二段階硝酸酸化によりSi(100)及びSi(111)表面上に形成されたSiO2膜の膜厚
表1 二段階硝酸酸化によりSi(100)及びSi(111)表面上に形成されたSiO2膜の膜厚
 図1 二段階硝酸酸化により多結晶シリコン薄膜上に形成されたSiO2膜のTEM写真
図1 二段階硝酸酸化により多結晶シリコン薄膜上に形成されたSiO2膜のTEM写真
 図2 二段階硝酸酸化法により6インチSi(100)ウェーハ上に形成されたSiO2膜の面内膜厚分布
図2 二段階硝酸酸化法により6インチSi(100)ウェーハ上に形成されたSiO2膜の面内膜厚分布
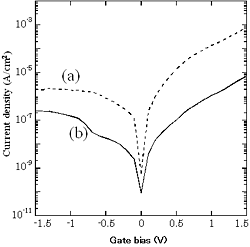 図3 二段階硝酸酸化法で形成したSiO2膜を持つ<Al/3.5nm SiO2/Si(100)> MOSダイオードの電流−電圧特性
図3 二段階硝酸酸化法で形成したSiO2膜を持つ<Al/3.5nm SiO2/Si(100)> MOSダイオードの電流−電圧特性
 図4 プラズマCVD酸化膜/シリコン構造のC-V曲線:a) 処理なし; b) 121℃の共沸硝酸で1時間処理; c) b)の試料を200℃で加熱処理; d) 熱酸化膜
表1に、二段階硝酸酸化法で形成されたSiO2膜厚を示す。Si(100)とSi(111)基板を酸化した際、酸化時間が4時間で両方とも約6nmのSiO2膜が形成された。つまり、二段階硝酸酸化法では、酸化速度の面方位依存性が存在しないことが確認された。800 ºC以上の高温を要する熱酸化では、Si(111)面の酸化速度はSi(100)面の酸化速度の約1.4倍であり、その結果種々の面方位が露出している多結晶シリコンを酸化した場合、均一な膜厚を持つSiO2膜は形成できない。一方、硝酸酸化法では、酸化速度の面方位依存性がないために、多結晶シリコン表面を酸化した場合にも均一な膜厚を持つSiO2膜が形成できると期待される。
図4 プラズマCVD酸化膜/シリコン構造のC-V曲線:a) 処理なし; b) 121℃の共沸硝酸で1時間処理; c) b)の試料を200℃で加熱処理; d) 熱酸化膜
表1に、二段階硝酸酸化法で形成されたSiO2膜厚を示す。Si(100)とSi(111)基板を酸化した際、酸化時間が4時間で両方とも約6nmのSiO2膜が形成された。つまり、二段階硝酸酸化法では、酸化速度の面方位依存性が存在しないことが確認された。800 ºC以上の高温を要する熱酸化では、Si(111)面の酸化速度はSi(100)面の酸化速度の約1.4倍であり、その結果種々の面方位が露出している多結晶シリコンを酸化した場合、均一な膜厚を持つSiO2膜は形成できない。一方、硝酸酸化法では、酸化速度の面方位依存性がないために、多結晶シリコン表面を酸化した場合にも均一な膜厚を持つSiO2膜が形成できると期待される。
図1に、TFT用多結晶シリコン薄膜を二段階硝酸酸化した後に観測した断面TEM写真を示す。共沸硝酸を用いての二段階目の酸化時間は、100分である。多結晶シリコン表面にはかなりの凹凸が存在するにもかかわらず、均一な膜厚、約10nmを持つSiO2膜が形成されていることがわかる。粒界領域が選択的に酸化されないこともわかる。均一な膜厚を持つSiO2膜の形成は、二段階硝酸酸化が、1) 直接酸化である、2) 面方位依存性が無いことによる。均一な膜厚のSiO2膜が形成されることによって、ゲート酸化膜の膜厚を低減でき、この結果TFTの消費電力が低減できる。
図2に、6インチウェーハを二段階硝酸酸化した結果、形成されるSiO2膜の膜厚分布を示す。二段階目の共沸硝酸を用いての酸化時間は5時間である。SiO2膜厚は13.1nm±0.6nmであり、膜厚分布は±5%である。
図3に、二段階硝酸酸化によって形成された3.5nmのSiO2膜を持つ<Al/SiO2/Si(100)>MOSダイオードの電流−電圧(I-V)曲線を示す。Al電極の形成後、5%水素+95%窒素中250 ºCで加熱処理を行なうことによって、リーク電流密度は約1/10に減少した。金属不純物濃度10ppt(1/1,000億)以下の超高純度硝酸を用いて酸化した場合、不純物濃度1ppb(1/10億)程度の硝酸を用いた場合に比較してリーク電流密度は約1/10に低減した。超高純度硝酸による酸化では、121 ºCの低温酸化にもかかわらず、800 ºC以上の高温が必要な熱酸化と同等の低いリーク電流が得られた。このように、二段階硝酸酸化では低リーク電流密度が達成できることから、TFTゲート酸化膜に利用した場合SiO2膜厚が低減でき、その結果駆動電圧の低減による低消費電力化が可能となる。
共沸硝酸に浸漬することによって、プラズマCVD法で形成されたSiO2膜を改質することができる。図4に、<Al/プラズマCVD-SiO2膜(38nm)/Si(100)>MOSダイオードの電気容量−電圧(C-V)曲線を示す。処理しない場合(曲線a)、C-V曲線はかなり負ケートバイアス領域に観測され、これはSiO2膜やSiO2/Si界面に正電荷が高密度で存在することを示す。共沸硝酸処理を1時間施した場合、C-V曲線は約2V正電圧方向にシフトして、正電荷密度が低減したことを示す。共沸硝酸処理後、200 ºCで加熱処理を施すことによってさらに正電圧方向にシフトして(曲線c)、熱酸化膜のC-V曲線(曲線d)とほぼ同じ位置に観測された。この結果は、CVD酸化膜の特性が、共沸硝酸処理によって熱酸化膜に近くなることを示すものである。共沸硝酸による改質は、酸素原子がSiO2中の欠陥準位に結合してそれが消滅することによると考えられる。
32×40cm2のガラス基板上に堆積された多結晶シリコン薄膜の硝酸酸化が可能な大面積基板TFT用の硝酸酸化装置を開発した。この装置を用いて多結晶シリコン薄膜の硝酸酸化の実験を行い、装置のパーツ材料の変更の必要性、硝酸酸化中の排気速度の変更の必要性等、種々の必要な改良点を発見した。これらの改良を、18年度に行う予定である。
硝酸酸化法を用いてゲート酸化膜を形成する場合、硝酸中の不純物金属がその特性に悪影響を及ぼすことがわかっている。液晶に使用されるガラス基材から共沸硝酸中に溶出する金属を調査した。石英製容器に試験片を入れ共沸硝酸を満たし、121 ºCで1時間加熱をした後、硝酸液を取り出しICP-MSで硝酸中に溶出した金属を分析した。素ガラス、多結晶シリコン膜付き、酸化膜付きの3種類についての分析結果を図5に示す。ガラスからAlとCaが、多結晶シリコンからCaとBaが多く溶出して、これらの金属不純物を除去する必要性があることがわかった。
 図5 共沸硝酸中に溶出した金属不純物濃度:a) ガラス基板; b) 多結晶シリコン; c) 酸化膜付多結晶シリコン
図5 共沸硝酸中に溶出した金属不純物濃度:a) ガラス基板; b) 多結晶シリコン; c) 酸化膜付多結晶シリコン
硝酸酸化によるTFT試料がまだ試作されていないので、現在、入手可能な多結晶TFTを用いてSPICEモデルの開発を行った。双方のTFTの電気的特性には共通の現象が発現すると想定されており、現行の多結晶シリコンTFTで開発したモデルとそのパラメータ抽出法が硝酸酸化膜TFTにも適用可能と考えられる。
TFTのSPICEモデルとしてRPIモデルを採用
RPIモデルでは、サブスレッショルド領域にはトラップの影響を組み込んだ拡散電流式、強反転領域についてはトラップに依存する移動度とDIBL効果を組み込んだドリフトの式を採用している。平成17年度はRPIモデルをSPICEに組み込み、実測値との比較を通して問題点の抽出とモデルの改良を行った。
実測との比較によるRPIモデルの問題点抽出
チャネル長とチャネル幅の異なる試料の実測結果から上記のモデルのデバイスパラメーター抽出を行った。その結果、(1)TFTのサブスレッショルド特性はRPIモデルでは不正確であること、(2)チャネル長が5μm以上の試料では強反転領域の実測値とモデル式との合致は良いものの、4μm以下の試料ではその違いが顕著になること、チャネル幅が50μm以上の試料ではゲート電圧が大きくなるほどモデル式との違いが明確になること、などが判明した。上記の(1)については、電子トラップの影響を正確に反映させるためにRPIサブスレッショルドモデルに改良を加えた。(2)については、短チャネル効果に起因するしきい値の低下を2次関数で表現していることに問題があることがわかった。(2)については、RPIモデルでは組み込まれていない自己発熱に起因する移動度の劣化が原因であることがわかった。
TFT評価用TEGの設計
現行のTFTの設計ルールに基づき、下記の2種類のTEGを設計した。 (1)近接するTFT特性のばらつきを自動測定するTEGの設計 TEG構造は、15個のTFTのソース、ドレインを共通とし、4ビットデコーダでゲート電極を選択する方式を採用した。個々のTFTのソース・ドレイン電位をケルビン法で自動制御する方式を用いた。TEG実測の結果、正常に動作することを確認した。 (2)TFT端子間容量測定用TEGの設計 ノンオーバーラップ信号をPチャネルTFTとNチャネルTFTに印加し、インバータ構造の出力端子に接続したキャパシタの容量を微少電流計測器で高精度に求める方法を採用した。今回、実測をした結果、容量値の周波数依存性が確認された。これはTFT膜内の電子トラップ分布が容量値に影響することを意味している。
3.研究実施体制
1. 「小林」グループ
(1) 研究分担グループ長:小林 光(大阪大学、教授)
(2) 研究項目
- 大面積TFT用硝酸酸化装置の開発
- 硝酸酸化プロセスの研究開発
- 硝酸処理によるプラズマCVD法で形成されたSiO2堆積膜の特性向上
- 新規欠陥消滅法による欠陥準位の消滅とTFTの高性能化
- 大面積TFTの硝酸酸化技術の開発
2. 「谷口」グループ
(1) 研究分担グループ長:谷口 研二(大阪大学、教授)
(2) 研究項目
- 硝酸酸化膜TFTのSPICEモデルの研究開発
2. 「今井」グループ
(1) 研究分担グループ長:今井 繁規(シャープ、参与)
(2) 研究項目
- 大面積TFT用硝酸酸化装置の開発
- 大面積TFTの硝酸酸化技術の研究開発
2. 「稲垣」グループ
(1) 研究分担グループ長:稲垣 精一(野村ピュア、社長)
(2) 研究項目
- 廃液硝酸の高純度化技術の開発
4.成果発表等
1. 論文(原著論文)発表 (国内 0件、国際 5件)
- S. Imai, M. Fujimoto, Asuha, M. Takahashi, and H. Kobayashi, Formation of atomically smooth SiO2/SiC interfaces at ~120 °C by use of nitric acid oxidation method, Surf. Sci. 600 (2006) 547-550.
- M. Takahashi, Y.-L. Liu, N. Fujiwara, H. Iwasa, and H. Kobayashi, Silicon cleaning and defect passivation effects of hydrogen cyanide aqueous solutions, Solid State Commun. 137 (2006) 263-267.
- H. Kobayashi, Asuha, S.-S. Im, S. Imai, and M. Takahashi, Nitric acid oxidation of Si method for the formation of high quality Si/SiO2 structure at ~120 °C, AJAM (2006) 104-108.
- Y.-L. Liu, N. Fujiwara, H. Iwasa, M. Takahashi, S. Imai, and H. Kobayashi, Defect passivation etch-less cleaning method for Si devices, Surf. Sci. 600 (2006) 1165-1169.
- E. Pincik, H. Kobayashi, J Rusnak, M. Takahashi, R. Brunner, M. Jergel, A. Morales-Acevedo, L. Ortega, and J. Kakos, Passivation of Si and a-Si:H surfaces by thin oxide and oxynitride layers, Appl. Surf. Sci. in press.
2. 特許出願
累計数
1) 平成17年度特許出願(国内 2件、海外 0件)
2) CREST研究期間累積件数(国内 2件、海外 0件)
本年度分内訳
3) 国内出願(2件)
4) 海外出願(0件)
3. 新聞報道
2005年11月15日、朝日新聞朝刊、研究最前線インタビュー(小林 光)




