
- 飛行時間型二次イオン質量分析装置 FIB-TOF-SIMS
- 単一微粒子の履歴解析装置;有機物が計れるイオンビーム質量分析とナノスケール質量イメージング
-
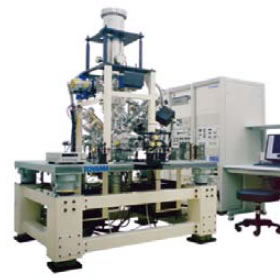
- 飛行時間型二次イオン質量分析装置 FIB-TOF-SIMS
メーカー名 :
(株)トヤマ製品の紹介(特徴など) :
大気中に浮遊している微粒子などを切断し、質量分析をすることが可能な装置です。製品情報URL :
http://www.toyama-jp.com/products/analyzer/filmer.html
Keyword : 大気浮遊粒子状物質、収束イオンビーム -
この課題の詳細はこちら
 (日本語版) 先端計測成果集より
(日本語版) 先端計測成果集より
-
開発課題名 収束イオンビーム/レーザーイオン化法による単一微粒子の履歴解析装置 チームリーダー 藤井 正明(東京工業大学 教授) 参画機関 新日本製鐵(株)、分子科学研究所、工学院大学 開発期間 平成16年〜21年度 開発概要 ナノスケール加工可能な収束イオンビームと特定の分子種を選択検出できるレーザーイオン化を融合した新たな局所分析法により、微粒子の表面と内部の組成の違いを計測する単一微粒子履歴解析装置を開発します。有害な大気浮遊粒子状物質のうち環境場や発生起源に特徴的な微粒子に適用し、年輪の様に刻まれている組成分布情報から発生源や浮遊履歴を解明します。これにより汚染物質の生成機構を明確化する事で環境科学に貢献します。



![]()

