| (1) |
マルチポリゴン光走査装置ユニット |
|
マルチポリゴン光走査装置ユニットの開発目的 |
|
 |
現在,レーザー走査装置は多くのアプリケーションがありますが,①装置が大きく高価,②レーザースポット径が大きい,③走査むら(ジッター)が大きい,④走査範囲が狭い,⑤汎用的に利用できない,といった問題点を抱えています。本装置では,これらを解決するために基本の光走査ユニットをベースとして,走査レンズ,受光ユニットなどを取付けることで,高精度かつ安価で応用範囲の広い,システマチックな光走査ユニットを提供いたします。さらに,規格化した本体ベースを用いて,これを多数個並べることによりマルチポリゴン光走査装置(特許申請中)となり,広範囲を高分解能で光走査を行なう,コストパフォーマンスに優れた装置が可能になります。 |
|
|
|
本走査装置ユニットの概略仕様 |
|
| ・レーザー走査方式 |
: |
ポリゴンミラーとfθレンズによる走査 |
| ・解像度 |
: |
2,540dpi |
| ・プロセススピード |
: |
26.67mm/sec |
| ・レーザー光源 |
: |
半導体レーザー650,830,780,450nm |
| ・像面スポットサイズ |
: |
φ12±5μm(650nm時) |
| ・1ユニット走査幅 |
: |
80mm |
| ・マルチ化時の走査幅 |
: |
80mm×連結ユニット数 |
| ・主走査方向位置制御 |
: |
専用電子制御回路 |
| ・副走査方向位置制御 |
: |
専用3軸位置制御ステージ |
| ・アプリケーション例 |
: |
印刷製版CTP,プリント基板直接描画,感光材料評価装置,レーザー計測等 |
|
 |
| |
|
| (2) |
超精密レンズ締結方法(シュリンクフィッタ法) |
|
シュリンクフィッタ法の特徴 |
|
従来のレンズの締結方法は,スペーサーによってレンズを光軸方向に押さえる方法が一般的です。この方法ではレンズと鏡筒の間にすきまがあるため,各々のレンズの偏心が生じます。また,僅かな温度変動や振動によってもレンズの位置ずれが生じて偏心量が増大します。このことにより,走査幅両端付近ではビーム径が大きくなってしまいます。
シュリンクフィッタ法では,レンズを締りばめするので各レンズの光軸が一致します。従って,全走査領域にわたってレーザーを微細に絞り込むことが可能です。また,温度変動が生じた場合でも,シュリンクフィッタの熱膨張によりレンズを常に一定の力で締結するため,光学性能の変化がありません。
(特許出願中:特願2001-65245) |
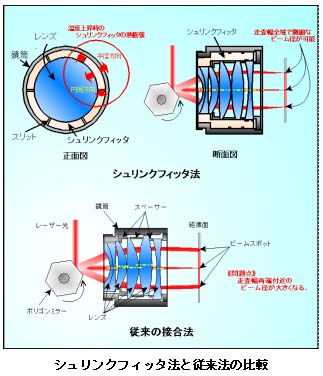 |
| |
|
|
レンズ系の光学性能評価 |
|
レンズ系の性能評価を行うために,レーザーを45°ミラーで走査させて結像面上のビームスポット径をビームプロファイラーで測定しました。また,温度補償性能を確認する目的で,レンズ系をカバーで覆い,温度を+5~+75℃に変化させました。なお,本実験で用いたレンズ系の諸元値は走査幅30mm,スポット径6μmです。
従来法で締結したレンズ系では走査幅両端付近でスポット径が大きく悪化しています。それに対して,シュリンクフィッタ法では全走査領域でほぼ理論値のスポット径になっています。シュリンクフィッタ法ではレンズの心出し性能が飛躍的に向上し,さらに優れた温度補償性能があることがわかります。 |
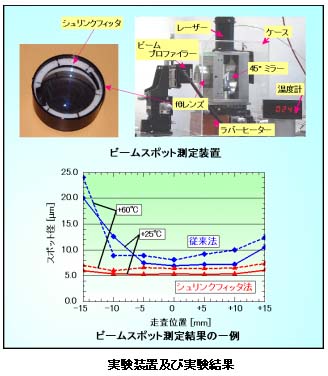 |
| |
|
| (3) |
レーザー感光材料評価システムへの応用 |
|
レーザー感光材料評価システムの概要 |
|
本光走査装置ユニットを使用してレーザーに感度を持つ感光材料の評価用装置を開発しました。本装置を用いることで,レーザー走査による感光材料の書き込み実験及び評価が低コストにでき,なおかつ自由どの高い実験が可能です。画像データはビットマップ形式を用い,パソコンから入力可能で,2,540dpi時に80×80mmの範囲を出力することが可能です。さらに,評価後は,この走査ユニットを多数個つなぐ事により広幅の感光体を走査することが可能になりますので,製品化を視野に入れた評価が可能になります。 |
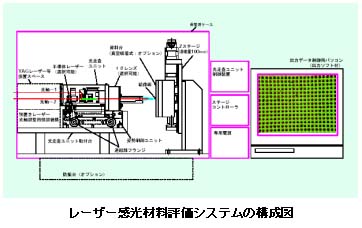 |
| |
|
|
本評価システムの特徴と仕様 |
|
| ① |
半導体レーザーの光源を選択できます。光走査ユニット内への組み込みを行い,標準品として650nmがありますが,405nm,635nm,780nm,830nm等の選択が可能です。 |
| ② |
レーザー走査幅は1ユニット80mmですが,2セット連結することで160mm幅の走査が可能です。2つのユニット間のつなぎ目は,独自のレーザー制御技術により最小になるように制御し,あたかも1台の走査装置を使っているような状態になります。この技術により,感光材料の評価装置と同じ程度の性能を持つ,大サイズのレーザー描画装置をすばやく製作することが可能です。このような装置の場合,出力スピードは従来品の10倍以上となる可能性があります。 |
| ③ |
結像点では微小なレーザースポット径で感光材料を露光することができます。例として650nmの半導体レーザーでφ12μm(1/e2)となります。 |
| ④ |
仕様上選択できる個所は,fθレンズの焦点距離とスポットサイズ,テレセントリック性に加えて,レーザーの波長,レーザーの個数,ポリゴンミラーの回転数,走査ユニットの数,Y軸ステージの移動距離,結像面の形状(平面かドラム),感光材料の取り付け方法などが選択できます。 |
| ⑤ |
オプションとしてパワーメータ,観察用顕微鏡,フォーカス検出装置,位置検出装置,レーザー投光器等を用意してあります。 |
|
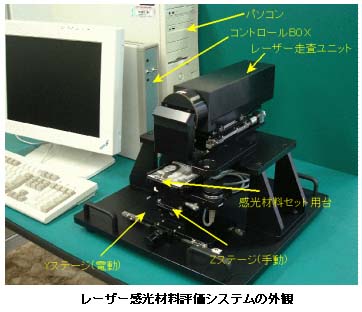 |