大阪大学 産業科学研究所の田川 精一 招へい教授、大島 明博 招へい准教授らの研究グループは最先端の半導体デバイス製造のスループット(1時間あたりの半導体ウエハーの処理枚数)を10倍以上向上させる技術を開発しました。次世代の最先端の半導体デバイスの製造のためのリソグラフィ技術の本命として開発が進められている1台100億円と言われる極端紫外線(Extreme Ultra Violet:EUV)リソグラフィの露光装置では、露光光源のパワーが低いため、スループットが目標の10分の1程度と低いことが最大の課題でした。我々が体系化し、現在、世界中のレジストメーカーが開発の指針としている標準的な反応理論に基づいたレジストの高感度化は、ほぼ限界に近づいており、10分の1程度と低い露光パワーでは目標のスループットに到達できないので、現在、光源開発を待つ状態が続いています。我々は基本に立ち返って、露光プロセスと感光性樹脂(レジスト)の両方を同時に根本的に変革し、我々が体系化した標準的な反応理論に縛られない、10分の1程度の低いパワーのEUV露光でもレジストの反応性を高めて目標のスループットに到達できる新しい技術体系を開発しました。
これにより、長年にわたって、産業界が望んでいた次世代のリソグラフィ技術の本命であるEUVリソグラフィの早期の実用化が実現することになります。
本成果は、科学技術振興機構の戦略的創造研究推進事業 チーム型研究(CREST)「極微細加工用レジスト研究とプロセスシミュレーターの開発(平成19~24年度)」(研究総括:渡辺 久恒、研究代表者:田川 精一)によって得られました。
<研究の背景と内容>
従来のEUV露光プロセスでは、1回のEUV露光によってレジスト中に酸が発生することにより反応が進みます。本研究により開発した技術では、微細パターンを形成するEUV露光と高感度化のための光全面露光の2回の露光を行うことによって、微細パターンを高感度で形成します。まず、最初のEUV露光で酸と同時に光増感剤をレジスト中に発生させます。
2回目の光全面露光では1回目のEUV露光で生成した光増感剤のみが光を吸収する波長の光全面露光を行うことにより、1回目のEUV露光を行った部分のみに再び酸と増感剤を発生させます。このEUV露光部の選択的増感反応により10倍以上の酸増殖ができ、少ないEUV露光量でも反応に必要な十分の量の酸を発生させることができます。この酸増殖反応は室温で起こるので、酸増殖時に酸の拡散がないので解像度を維持したままレジストの大幅な高感度化が可能になります。
<本研究成果が社会に与える影響>
本研究成果によりEUV露光プロセスの最大の課題であったスループットを大幅に改善することができます。スループット問題の解決は、次世代のリソグラフィ技術の本命として開発が進められているEUVリソグラフィ技術による半導体製造を実現することができ半導体デバイスの高集積化を支えることができます。
本件の開発内容は、千葉大学にて開催される第30回国際フォトポリマーコンファレンスにおいて平成25年6月28日(金)に発表します。
<参考図>
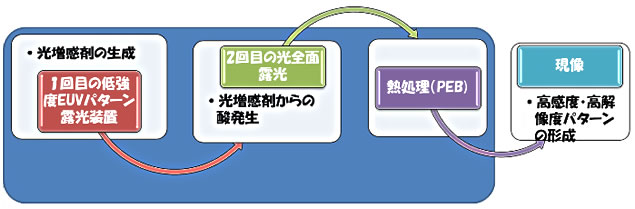
図1 新露光システム
EUVパターン露光・光全面露光よる革新的プロセスのシステム
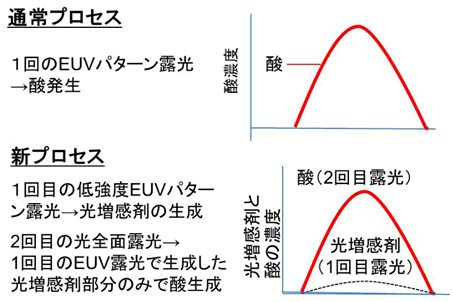
図2 通常プロセスと新プロセスとの比較の簡略図
<お問い合わせ先>
<研究内容に関すること>
田川 精一(タガワ セイイチ)
大阪大学 産業科学研究所 ナノ極限ファブリケーション研究分野 招へい教授
Tel:06-6879-8408 Fax:06-6876-3287
E-mail:
<JSTの事業に関すること>
木村 文治(キムラ フミハル)
科学技術振興機構 戦略研究推進部 ICTグループ
Tel:03-3512-3526 Fax:03-3222-2064
E-mail:
<報道担当>
大阪大学 産業科学研究所 広報室
Tel:06-6879-8524 Fax:06-6879-8524
E-mail:
科学技術振興機構 広報課
Tel:03-5214-8404 Fax:03-5214-8432