JST 課題解決型基礎研究の一環として、東京大学大学院工学系研究科の鳥海 明 教授らは、電子・正孔ともに世界最高の移動度注1)を持つゲルマニウムを用いた絶縁ゲート型電界効果トランジスター注2)の開発に成功しました。
低消費電力デバイスを構築する上でCMOS(Complimentary MOS)注3)技術は欠かせません。現在はシリコンCMOSが主流ですが、次世代CMOSの高性能化に向けてトランジスターのスイッチ速度に直結する飛躍的に移動度が高いトランジスターの実現が望まれています。多くの半導体材料の中で、半導体固有の移動度が電子・正孔ともにシリコンよりも格段に優れている材料はゲルマニウム以外にありませんが、ゲルマニウム上に安定的な絶縁膜を作製できなかったため、絶縁膜との界面で動作させる電界効果トランジスターにおいては、電子・正孔ともに高い移動度を実現することは不可能と考えられてきました。
本研究グループは本年6月、ゲルマニウム基板の酸化過程の見直しからプロセスを構築することによって、世界最高の電子移動度を持つゲルマニウムトランジスターの実現を報告しました。しかし、材料科学的にはさらなる向上が予測され、またCMOS化を前提に正孔における移動度の改善が必要であることから、今回界面の抜本的改善に焦点をあててトランジスター作製過程を見直しました。その結果、従来のシリコン基板上の電界効果トランジスターの移動度と比べて、電子で2.5倍、正孔で3.5倍という最高性能のトランジスターを実証しました。これは15nm(ナノメートル、10億分の1m)技術世代以降のCMOS用基板材料としてゲルマニウムの極めて大きな可能性を示すものです。
今回の研究成果は、2010年12月6日から8日(米国太平洋標準時間)に米国・サンフランシスコで開催される「電子デバイス国際会議(IEDM)」で発表されます。
本成果は、以下の事業・研究領域・研究課題によって得られました。
戦略的創造研究推進事業 チーム型研究(CREST)
| 研究領域 |
: |
「次世代エレクトロニクスデバイスの創出に資する革新材料・プロセス研究」
(研究総括:渡辺 久恒 (株)半導体先端テクノロジーズ 代表取締役社長)
|
| 研究課題名 |
: |
「Ge High-k CMOSに向けた固相界面の理解と制御技術の開発」 |
| 研究代表者 |
: |
鳥海 明(東京大学大学院工学系研究科 マテリアル工学専攻 教授) |
| 研究期間 |
: |
平成20年10月~平成26年3月 |
JSTはこの領域で、革新的かつ実用化可能なエレクトロニクスデバイスを創製するための材料・プロセスの研究開発を推進しています。上記研究課題では、Ge系材料の熱的、電気的安定性が悪い弱点を克服し、高速・低消費電力デバイス実現に向けた研究を推進しています。
<研究の背景と経緯>
情報技術の進展は、シリコンを用いたトランジスターの微細化よって成し遂げられてきたといっても過言ではありません。しかし、最先端トランジスターのゲート長はすでに50nm以下にまで微細化され、さらなる性能の向上を実現するにはシリコンという材料の見直しが迫られています。一方、性能だけではなく消費電力の削減が喫緊の問題として半導体技術に課せられてきていることも見逃せません。現在新しいトランジスター材料に要求される事項として、次の3点があげられます。
- i) 集積化を前提にCMOS構造をコンパクトに実現できること。
- ii) 電子・正孔ともに移動度がシリコンに比べて十分に高いこと。
- iii) サブスレッショールド電流注4)を十分に抑えたトランジスターを実現できること。
新しい材料を用いる場合に、材料の変更によって従来シリコンで達成されてきた利点を失うのであれば総合的には性能を落とすことになりかねません。また、電子・正孔をそれぞれ独立に異なる材料で移動度を向上させる手法では、現実的に集積回路を作製する観点からi)の集積化の実現が極めて難しいと考えられます。
以上の観点から、本研究グループではシリコンに代わる材料としてゲルマニウムに着目し、電界効果トランジスターで最も重要な絶縁膜との界面の理解と制御の研究を進め、今年6月に米国・ハワイで開催された「VLSIシンポジウム」において、ゲルマニウムについて今まで不可能とされてきた電子の移動度に関して世界最高の結果を実証してきました(平成22年6月18日プレスリリース https://www.jst.go.jp/pr/announce/20100618/index.html)。
今回の研究は上記要求項目のうち、i)CMOSという観点から電子だけでなく正孔においても実際に飛躍的な移動度向上は可能か、ii)電子の移動度はもう限界値なのか、あるいはさらに向上可能なのか、iii)サブスレッショールド電流を十分抑えられるのか、という3点に焦点をあて研究を進め、結果的にゲルマニウムは上記の要求項目の実現を可能にする材料であることを強く示すことができました。
<研究の内容>
以上のような背景・経緯のもと、本研究グループではゲルマニウムを用いた電界効果トランジスターの高性能化に対する指針を構築し、それを実証する研究を進めてきました。ゲルマニウム基板上の絶縁膜二酸化ゲルマニウム(GeO2)とその界面の安定化に関しては、すでに高圧酸化という手法を用いることによって一酸化ゲルマニウム(GeO)の発生を熱力学的に抑え、極めて良好なゲートスタック構造を実現することに成功しています。しかし、この手法が界面に対しても最適な条件であるということは保証されていません。そこで今回はまさにその部分に焦点をあてて考えることで、界面特性の飛躍的向上を図り、これにより上記要求項目のii)、iii)が大きく改善するものを目指しました。
界面のGeOに関する平衡蒸気圧を熱力学的に考えると、温度を決めたならばGeOの平衡蒸気圧はGibbs(ギブス)の相律から一意的に決まります。つまり比較的高温で高圧酸化を施すことによってGeO2膜の膜質は圧倒的に改善されるのですが、界面ではまさにその温度によって決まるGeOの生成が起きることになります。これは本質的なことであるため克服することは不可能と思われていましたが、これを2つの方法で乗り越えました。
1点目は、酸素雰囲気下での低温熱処理です。つまり高圧酸化によって形成された良好なGeO2膜質を損なわずに界面におけるGeOの平衡蒸気圧を下げるために、高圧酸化の温度よりも低温で酸素熱処理することです。ただし、あまりに低温であると現実的な時間で処理できないため、この温度と時間をうまく探し出せるかがポイントになります。これに対して、ゲルマニウム表面からGeOの脱離がおよそ430℃辺りから始まるという実験結果をもとに、酸素アニール温度を400℃と設定しました。
2点目は、規則配列した結晶中をある特定方向で切ったときに現れた面を示す「面方位」に対する選択です。同じ膜厚のGeO2がゲルマニウム基板上に堆積される時にGeOの脱離が始まる温度が面方位によって異なるという事実を見いだしました。具体的には、面方位を(100)、(110)、(111)面で比較した時に(111)面がGeOの脱離に対して最も安定であることが実験でも確かめられました。このことは、(111)面上ではGeO脱離が起きにくく他の面に比べて安定になりやすいことを示しています。電子にとって有効質量の観点から(111)面が優位であるということ(有効質量の面方位依存性注5))は本年6月の「VLSIシンポジウム」でも議論しましたが、界面の構造的安定性からも優位であることを意味しています。
以上の知見をもとにゲルマニウム電界効果トランジスターを下記のように作製しました。
p型(111)面ゲルマニウム基板上にNチャネル型絶縁ゲート型電界効果トランジスターを、また、n型(100)ゲルマニウム基板上にPチャネル絶縁ゲート型電界効果トランジスターを作製しました(図1)。またそれぞれの面上にMOSキャパシターを作製し界面欠陥密度を評価しました。なお、Pチャネル電界効果トランジスターでは有効質量の観点から(111)面の優位性はないので(100)面を使いました。
MOSキャパシターにおける容量-電圧特性の周波数依存性の詳細評価から、フォーミングガスアニール注6)を施していないにも関わらず、バンド端側における界面欠陥密度が大きく減少していることが分ります(図2)。
電界効果トランジスター性能としては、電子移動度が約1,920(cm2/Vsec)、正孔移動度が725(cm2/Vsec)という世界最高の電子移動度、正孔移動度を達成しました(図3)。これはシリコンの電子移動度の約2.5倍、正孔移動度の約3.5倍にあたり、現在しのぎを削って研究開発がなされている歪みシリコン注7)FETにおける移動度向上を大きく超えるものです。また電子移動度に関しては、本年6月に本研究グループが発表した結果(1,480cm2/Vsec)をも大きく超えるものです。また界面が改善したことによって、移動度の温度依存性はシリコンMOSFETと同様な振る舞い(温度低下とともに移動度が上昇する)を示すことができました。すなわち半導体固有の性質をゲルマニウムでも初めて実現できたのです。
サブスレッショールド・スロープも小さく、界面特性が向上していることが分かりました(図4)。さらに、界面特性が向上したことによって、しきい値以下の電流を示す特性(サブスレッショールドスウィング)をシリコン並みに改善することができました。実際、このことも従来ゲルマニウム電界効果トランジスターの大きな問題でした。この特性が改善されないと低電圧動作は難しく、本結果は現実的に低電圧動作CMOSを考える際に移動度と同程度に重要な結果と言えます。
このように、今回の結果は界面の理解と制御によって電界効果トランジスターの基本性能を電子・正孔ともに飛躍的に向上できることを示したもので、ゲルマニウムCMOSの可能性を大きく高めました。
一方、ゲルマニウム界面特性を改善するために極めて薄いシリコン膜を界面に挿入するという技術が世界各地で研究されています。極薄シリコンを界面に挿入すると正孔の場合には界面を向上させることがありうるため、今回この技術も同時に検討しましたが、電子の場合には劣悪な界面を作ることが分りました。このことは、シリコン挿入技術の改良ではCMOS化は難しいことを明瞭に示しています。
<今後の展開>
さらなるプロセスの最適化あるいはゲルマニウムに対する歪み技術の適用によって、今回の結果をさらに凌駕する高性能化が期待できます。また微細化に向けてはゲート絶縁膜をさらに薄膜化する必要があり、高誘電率絶縁膜の適用が鍵になります。さらにトランジスターの高性能化に対しては、ソースとドレイン部における不純物の制御、接触抵抗の低抵抗化も重要です。これらに関しても抜本的な改善を図るには界面の理解と制御が鍵となることから、現在精力的に研究を進めています。
<参考図>
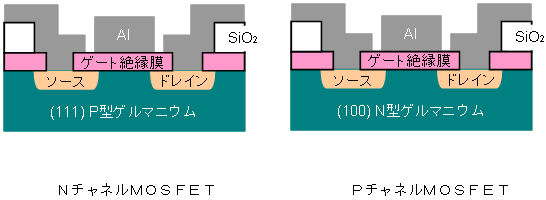
図1 今回開発されたNチャネル、Pチャネルゲルマニウム・トランジスターの模式図
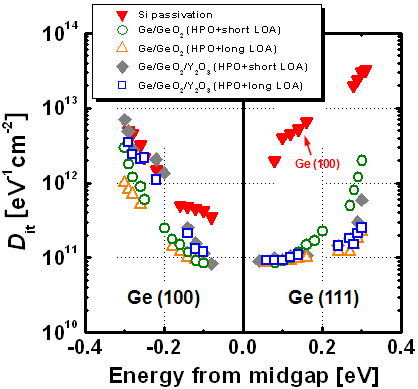
図2 トランジスターの基本になるMOS(金属・酸化膜・半導体)型キャパシターの容量-電圧特性から求めたゲルマニウム基板における欠陥界面準位のスペクトル
各種プロセス、ゲートスタック構造の結果を示す。ミッドギャップ付近で1011eV-1cm-2以下が実現されている。今回の特性は特にバンドギャップ端に向かって界面準位密度が改善されていることが移動度改善に大きく寄与している。
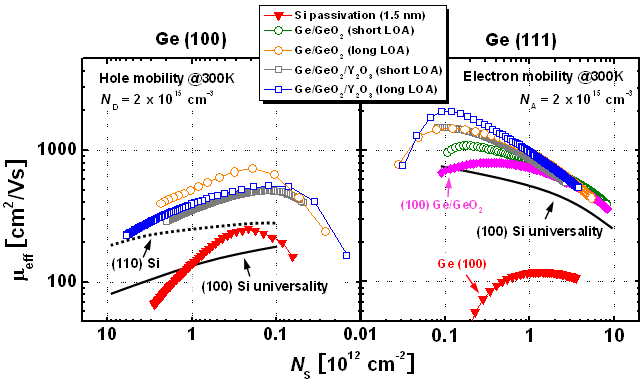
図3 室温における電子・正孔の移動度の界面におけるキャリア面密度依存性
各種プロセス、ゲートスタック構造の場合について示している。電子と正孔の移動度に関して、上図において最も高い値は報告されている値の中で電子・正孔ともに世界最高値である。
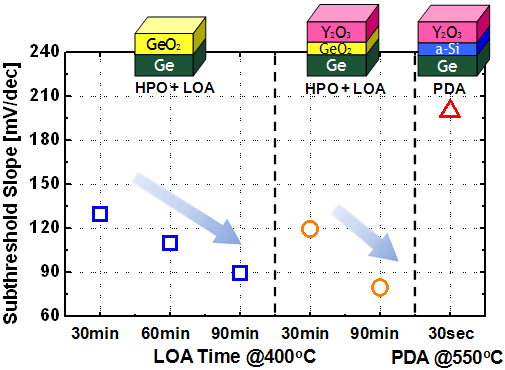
図4 室温におけるn-チャネルMOSFETにおけるサブスレッショールド・スロープのプロセスおよびゲートスタック構造による違い
長時間低温酸素アニールによる改善が明瞭に示されている。
<用語解説>
- 注1) 移動度
- トランジスターのスイッチングは半導体中を走行するキャリア(電子と正孔)によって達成されますが、その走行速度が速いほどスイッチとしての性能は高くなります。その指標の1つが移動度です。正確には、キャリアの速度とキャリアにかかっている電界との比例係数として表されます。つまり、移動度が高いということはキャリアに対して、僅かな電界で速い速度を実現できることを意味しており、高性能・低消費電力を実現するための最も重要な指標になります。電子と正孔とでは移動度を律速している要因は異なることがあり、それぞれ詳細に調べる必要があります。
- 注2) 絶縁ゲート型電界効果トランジスター
- 現在幅広く使われているCMOS技術では、全てこの型のトランジスターが用いられています。図1の模式図は、この型のトランジスターの典型的な断面構造を示しています。
- 注3) CMOS(Complimentary MOS)
- NチャネルMOSFETと、PチャネルMOSFETから構成された低消費電力回路。電源はNチャネルMOSFETとPチャネルMOSFETに直列に接続されているため、ゲート入力の如何にかかわらず定常状態では接地線とは電気的につながらず、無駄なリーク電流は最小限に抑えられます。
- 注4) サブスレッショールド電流
- トランジスターにおいて無駄な消費電力を削減するためにはリーク電流を抑えること、特にしきい値以下の電流を効率的に抑制することが重要で、この部分をサブスレッショールド電流と呼びます。半導体基板界面に欠陥が多いと、この電流が大きくなってしまうため、界面を改善することで急峻な立ち上がりが実現できるようになっています。電流の傾き(急峻性)の指標として、サブスレッショールド・スロープという量が使われます。
- 注5) 有効質量の面方位依存性
- シリコンとゲルマニウムでは電子に対する等エネルギー面が異なるため、電界効果トランジスター動作をする際に形成される反転層電子の有効質量に対する面方位依存性が異なってきます。シリコンにおいては従来(100)面が使われてきましたが、ゲルマニウムでは電子に関しては(111)面の方が軽い有効質量を実現するという観点から有利になります。一方、正孔に関しては、等エネルギー面が複雑であるために電子ほど明瞭ではなく、有効質量がキャリア数によって変化し最適な面が必ずしも一意的には決まらないことが分ります。今回の実験結果もそのことを明快に示しています。
- 注6) フォーミングガスアニール
- 表面の均質化などを目的に、水素と窒素などのような混合ガス(フォーミングガス)雰囲気中で、一定時間高温に保つ処理。界面を改善するために一般的に行われるものです。
- 注7) 歪みシリコン
- 現在、最先端シリコンデバイスでは、シリコンそのものに材料的に歪みを加えることで電子構造を僅かに変調させ、キャリアの実効的な有効質量を軽くし、通常のシリコンの場合よりも高い移動度を実現しています。この技術は電子や正孔両方に対して使われています。
<論文名>
“Ge MOSFETs Performance : Impact of Ge Interface Passivation”
(Ge MOSFETの性能:Ge界面の安定化のインパクト)
doi: 10.1109/IEDM.2010.5703384
<お問い合わせ先>
<研究に関すること>
鳥海 明(トリウミ アキラ)
東京大学大学院工学系研究科 マテリアル工学専攻 教授
〒113-8656 東京都文京区本郷7-3-1
Tel:03-5841-7120 FAX:03-5841-7158
E-mail:
<JSTの事業に関すること>
長田 直樹(ナガタ ナオキ)
科学技術振興機構 イノベーション推進本部 研究領域総合運営部
〒102-0075 東京都千代田区三番町5 三番町ビル
Tel:03-3512-3524 Fax:03-3222-2064
E-mail: