JST 課題解決型基礎研究の一環として、東京大学 大学院工学系研究科の鳥海 明 教授らは、世界最高性能の移動度注1)を持つゲルマニウムを用いたトランジスターを開発しました。
現在使われているトランジスターはシリコンを用いたものが主流ですが、次世代に向けてその性能を抜本的に凌駕(りょうが)する技術の開発が望まれていました。
その中でゲルマニウム単結晶におけるキャリア移動度は、電子、正孔ともにシリコンよりも格段に優れていることから、ゲルマニウムトランジスターが注目されています。しかしゲルマニウムでは、シリコンのように容易で安定な“ゲート絶縁膜注2)の作成”が困難でした。
そこで本CRESTチームは、ゲルマニウムでゲート絶縁膜を作成する方法を、材料科学的な新たな観点で設計し、これによって従来のシリコントランジスターと比べて移動度が約2倍に上がることを実証しました。
今回開発された技術は、低電圧で高性能に動作するトランジスターの開発につながるものであり、シリコンで培われてきた情報通信技術の飛躍的発展に役立つことが期待されます。
本研究は、2010年6月15日から17日(米国ハワイ時間)に米国・ハワイで開催される「VLSIテクノロジーシンポジウム」で発表されます。
本成果は、以下の事業・研究領域・研究課題によって得られました。
戦略的創造研究推進事業 チーム型研究(CREST)
| 研究領域 |
: |
「次世代エレクトロニクスデバイスの創出に資する革新材料・プロセス研究」
(研究総括:渡辺 久恒 (株)半導体先端テクノロジーズ 代表取締役社長)
|
| 研究課題名 |
: |
「Ge High-k CMOSに向けた固相界面の理解と制御技術の開発」 |
| 研究代表者 |
: |
鳥海 明(東京大学 大学院工学系研究科 マテリアル工学専攻 教授) |
| 研究期間 |
: |
平成20年10月~平成26年3月 |
JSTはこの領域で、革新的かつ実用化可能なエレクトロニクスデバイスを創製するための材料・プロセスの研究開発を推進しています。上記研究課題では、Ge系材料の熱的、電気的安定性が悪い弱点を克服し、高速・低消費電力デバイス実現に向けた研究を推進しています。
<研究の背景と経緯>
情報技術の進展は、シリコンを用いたトランジスターの微細化による劇的な高性能化によって成し遂げられてきたといっても過言ではありません。しかし、トランジスターの微細化はすでに50nm(nm=10億分の1m)以下にまで到達し、性能の向上が飽和しつつあります。一方で、性能だけではなく消費電力の削減が喫緊の問題として半導体技術に課せられてきていることも見逃せません。この原因としては、シリコンという材料に起因した部分と、トランジスターから構成されるシステムの問題とに分けて考えることができます。今回の研究開発は、特にシリコンからゲルマニウムに材料を変更することによって、性能の飽和や消費電力の削減という重要な問題を大きく改善しようというものです。
しかし、材料の変更によって従来シリコンで達成されてきた利点を失うのであれば、総合的には性能を落とすことになりかねません。また、システム設計技術を大きく変えるものになっては従来の技術資産を使えなくなってしまいます。
歴史的には世界最初のトランジスターや世界最初の集積回路もゲルマニウム上に作成されていることから、半導体としてゲルマニウムが優れた性能を持つことは、昔から認識されていました。例えばゲルマニウム単結晶におけるキャリア移動度は電子、正孔ともにシリコンよりも格段に優れています。ただし、シリコンならば容易かつ極めて安定に作成できる「ゲート絶縁膜」をゲルマニウムで作成することが大変難しかったため、これまで大規模の商用製品に使われてきませんでした。
一方シリコン集積回路技術においては、その安定な絶縁膜である二酸化シリコン(SiO2)の薄膜化が著しく進められ、すでに絶縁性の限界に達しています。それに替わるべく高誘電率ゲート絶縁膜の研究が実用化レベルで進んでいることから、“ゲート絶縁膜には安定なシリコン酸化膜”という従来の常識から離脱することへの要請が高まっていました。
<研究の内容>
このような背景のもと本研究グループでは、ゲルマニウムを用いたトランジスターの移動度の高性能化と、ゲルマニウム界面の安定化を実現する指針を構築し、それを実証する研究を進めてきました。その結果、画期的な性能を持つゲルマニウムトランジスターを実証することに成功しました(図1)。
ゲルマニウムと絶縁膜の界面の安定化に関して、まず、熱力学的な考察および要素的な実験を繰り返すことによって、界面に起因した一酸化ゲルマニウム(GeO)の発生をいかに抑えるか、いかに安定化させるかという点に関する指導原理を構築しました。GeOが発生するということは界面で二酸化ゲルマニウム(GeO2)の分解が起きることを意味し、界面を劣化させていると考えたからです(図2)。また、ゲルマニウムの酸化膜であるGeO2膜は水に溶解しやすく、トランジスターを作成するプロセスで大きな支障になるため、表面は常にGeO2膜以外の材料で構成できるようにすることが必要です。
具体的には、
- 1) ゲルマニウムを酸化する際の酸素圧力を上げることで、表面におけるGeOの平衡蒸気圧を低下させ、GeOの表面からの脱離を大幅に抑制しました。
- 2) ゲルマニウム基板上の界面で生成したGeOが界面近くに残った場合に対して、低温における酸素熱処理を施すことによって、界面におけるGeOの平衡蒸気圧を著しく低下させることで、残留GeOを減少させました。
さらにゲルマニウムに比べて酸素が不足気味でも安定化物を形成する酸化物を導入することによって、圧倒的に界面のGeOの削減に配慮しました。具体的には希土類金属注3)酸化膜をGeO2中に導入することで、これを達成しました。
- 3) 水に対する耐性がある希土類酸化膜としてイットリウム酸化物(Y2O3)を選択しました。
上記の材料科学的なトランジスター形成プロセス指針に加えて、ゲルマニウムの電子の有効質量の面方位依存性注4)を考慮し、p型(111)面ゲルマニウム基板上に絶縁ゲート型電界効果トランジスター注5)を作成したところ、約1,500(cm2/Vsec)という世界最高性能の電子移動度を持つゲルマニウムトランジスターの開発に成功しました(図3、4)。これはシリコンの電子移動度の約2倍にあたり、現在、しのぎを削って研究開発がなされている歪みシリコン注6)における移動度上昇を超えるものです。また昨年、本研究グループが発表した結果をも大きく超えるものです。
<今後の展開>
界面の改善あるいは歪み技術の採用によって、ゲルマニウムは今回の結果以上の高性能化が可能性です。また今後、ゲルマニウムのバンドギャップ注7)がシリコンの半分程度である性質を利用することによって、低電圧でシリコンの性能を圧倒的に凌駕(りょうが)するトランジスターを開発することが可能になります。
<参考図>
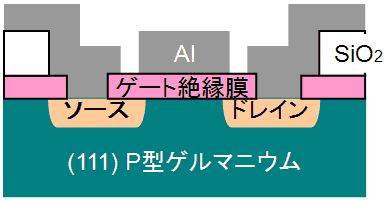
図1 ゲルマニウムトランジスターの模式図
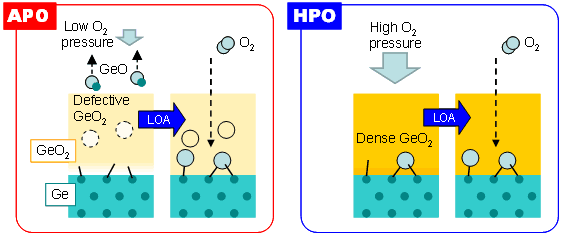
図2 良質なゲルマニウム酸化膜の作成プロセスと、酸化過程のモデル図
APO(Atmospheric Pressure Oxidation;大気圧酸化)、HPO(High-Pressure Oxidation;高圧酸化)、LOA(Low Temperature O2 Annealing;低温酸素アニール)を表しています。
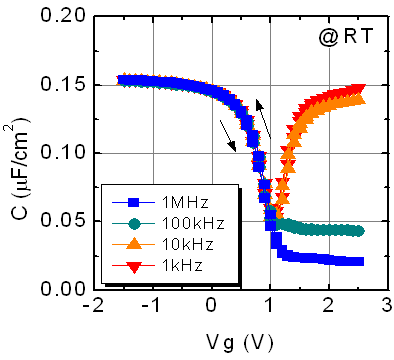
図3 トランジスターの基本になるMOS(金属・酸化膜・半導体)型キャパシタの容量-電圧特性(ほぼ理想に近い特性が得られている)
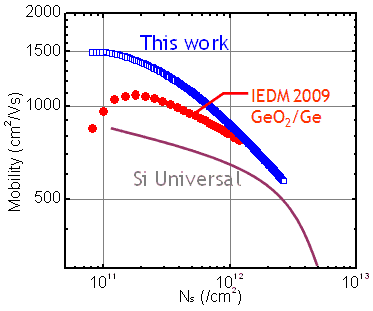
図4 電子移動度の界面電子数依存性
GeO2だけで絶縁膜を構成した場合(IEDM2009での本研究グループからの発表結果:赤線)とシリコンの普遍モビリティ(紫線)。
<用語解説>
- 注1) 移動度
- トランジスターのスイッチングは半導体中を走行するキャリアによって達成されますが、その走行速度が速いほどスイッチとしての性能は高くなります。その指標の1つが移動度です。正確には、キャリアの速度とキャリアにかかっている電界との比例係数として表されます。つまり、移動度が高いということはキャリアに対して、僅かな電界で速い速度を実現できることを意味しており、高性能・低消費電力を実現するためのもっとも重要な指標になります。
- 注2) ゲート絶縁膜
- ゲート電極と半導体基板(チャネル)を絶縁する(コンデンサの役割を持つ)電界効果型トランジスターを構成する膜。
- 注3) 希土類金属
- 周期表において、第三族のうち第4周期のスカンジウム(Sc)、第5周期属のイットリウム(Y)、および第6周期のランタン系列と呼ばれるランタン(La)からルテチウム(Lu)までの元素を希土類金属と呼ばれます。これらの元素は化学的性質が極めて似ていることが特徴です。今回の研究では、イットリウム(Y)が用いられました。
- 注4) 有効質量の面方位依存性
- シリコンとゲルマニウムでは電子に対する等エネルギー面が異なるため、電界効果トランジスター動作をする際に形成される反転層電子の有効質量に対する面方位依存性が異なってきます。シリコンにおいては従来(100)面が使われてきましたが、ゲルマニウムでは(111)面の方が軽い有効質量を実現するという観点から有利になります。
- 注5) 絶縁ゲート型電界効果トランジスター
- 現在幅広く使われているCMOS技術では、全てこの型のトランジスターが用いられており、図1の模式図はこの型のトランジスターの典型的な断面構造を示しています。
- 注6) 歪みシリコン
- 現在、最先端シリコンデバイスでは、シリコンそのものに材料的に歪みを加えることで電子構造を僅かに変調させ、キャリアの実効的な有効質量を軽くし、通常のシリコンの場合よりも高い移動度を実現しています。この技術は電子、および正孔両方に対して使われています。
- 注7) バンドギャップ
- シリコンとゲルマニウムの半導体物性としてのもっとも大きな違いはバンドギャップです。室温において、シリコンは約1.12eV、ゲルマニウムで約0.67eVのバンドギャップを持つことが報告されています。バンドギャップが小さいことは基本的にはそれだけ小さい電圧で素子を動作させることができることを意味し、ゲルマニウムは今後の低消費電力化に向いた素子ということができます。
<論文名>
“Electron Mobility in High-k Ge-MISFETs Goes Up to Higher”
(高誘電率ゲート絶縁膜を用いたGe電界効果トランジスターの移動度はさらに向上)
<お問い合わせ先>
<研究に関すること>
鳥海 明(トリウミ アキラ)
東京大学 大学院工学系研究科 マテリアル工学専攻 教授
〒113-8656 東京都文京区本郷7-3-1
Tel:03-5841-7120 Fax:03-5841-7158
E-mail:
<JSTの事業に関すること>
長田 直樹(ナガタ ナオキ)
科学技術振興機構 イノベーション推進本部 研究領域総合運営部
〒102-0075 東京都千代田区三番町5 三番町ビル
Tel:03-3512-3524 Fax:03-3222-2064
E-mail: